PI 化学金属化&预鑽孔技术
聚醯亚胺膜(Polyimide, PI)作为软性铜箔基板的核心材料,短时间可承受高达400℃以上,搭配直接金属化製程可避免传统接着剂在高温下劣化的问题,提升FPC可靠性。 PMR採用湿式金属化(化学法)方式在PI薄膜上进行化学镀镍及电镀薄铜两个步骤。其优点为无接着剂结构、高附着力、优异热稳定性、极薄金属层、製程弹性与适合大规模量产,广泛应用于高阶软性电路板与电子产品。

PMR採用全新工艺在PI先进行雷射鑽孔再金属化的流程,称之为预鑽孔技术(Pre-drilled Technology),大幅简化FPC製造流程,提高软板生产效率,降低生产成本,不仅能针对各种设计需求进行灵活调整,同时完成面铜与孔铜的金属化,减少孔洞内金属断裂的风险,提升导通孔的信赖性,并且微小孔会直接填孔,可以取代複杂的盲孔製作。

透过替换合适的PI薄膜即可以实现不同的产品功能,例如高透明、低涨缩、超薄等特性,轻松满足各类应用需求。
| Base film | Features |
|---|---|
| Colorless PI |
TT 88~89%, Haze < 0.6% Tg 270 C Thickness 25,50um |
| Low CTE PI |
CTE 8 ppm/℃, Modulus 9 GPa Tg 340 C Thickness 12,25,38,50um |
| Ultra-thin PI |
CTE 8 ppm/℃, Modulus 9 GPa Tg 340 C Thickness 5~7µm |
半加成製程 (SAP Technologies)
PMR的半加成製程(Semi-Additive Process, SAP)是结合加成法(Additive Process)与减成法(Subtractive Process)优点的细线路电路板製程,具有高解析度、侧蚀小、线路品质稳定等优势。相较于改良式半加成(Modified Semi-Additive Process, mSAP)是以超薄铜箔基板(铜厚通常1~3μm)为起始材料,SAP则在聚醯亚胺膜(Polyimide, PI)上先进行鑽孔(Via drilling),并以直接金属化方式在聚醯亚胺膜(Polyimide, PI)上形成极薄的导电层。两者能做的线宽/线距都大幅优于传统减成法(Subtractive Process),mSAP可达20/20μm,SAP甚至可实现10/10 μm以下的极细线路。

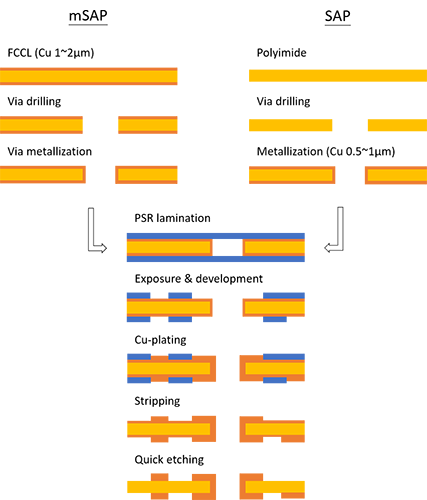
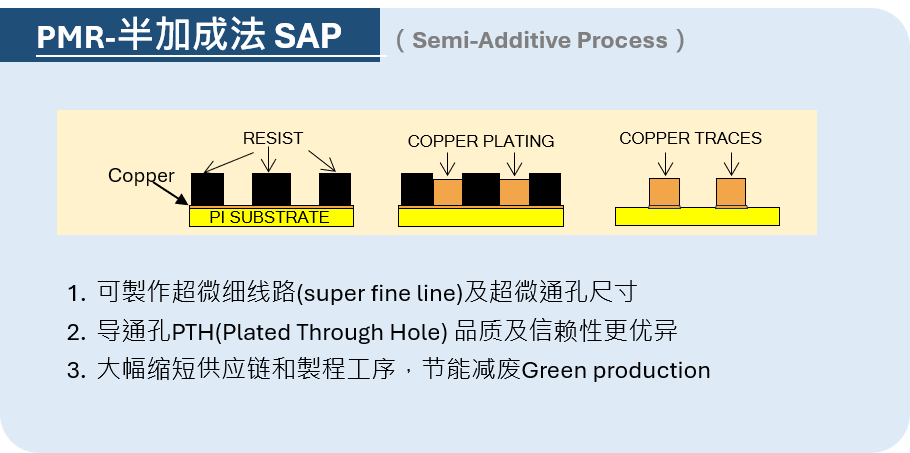
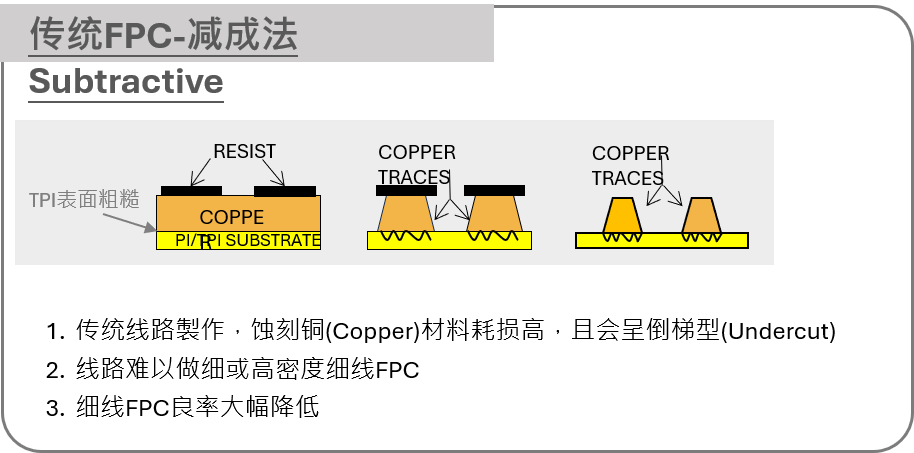
PI直接金属化+SAP线路製作
表面平滑度高,製作极细线路良率高
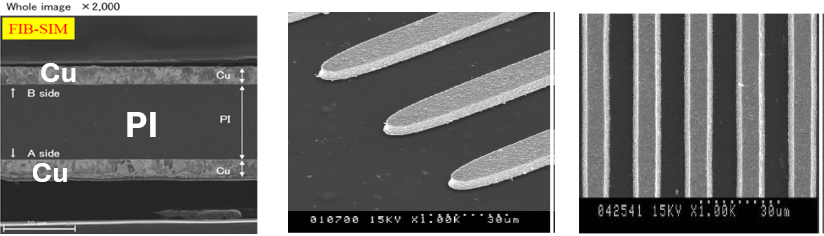
传统压合型 FCCL+减成法
(Subtractive)线路製作
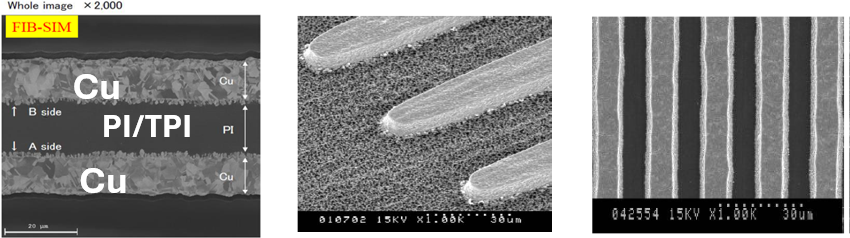
卷对卷超细线软性印刷电路板製造
微细线软性电路板
通常指的是具有极细线宽与线距(小于30μm甚至更细)的软性印刷电路板(Flexible Printed Circuit, FPC) ,结合了高密度配线、极佳柔韧性与轻薄特性,是现代电子产品朝向高密度、小型化、高可靠发展的关键基础零组件。其应用涵盖智慧型手机、穿戴式装置、车用电子、医疗、航空航太等多个领域。

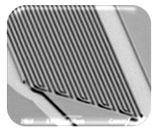

PMR採用卷对卷(Roll-to-Roll, RTR)生产技术
搭配自有的PI金属化技术以及SAP (Semi-Additive Process)加工技术,是製造超微细线路软性电路板的关键方法,适用于超薄聚醯亚胺基材,避免传统製程中因频繁搬运造成的基板皱摺或汙染。全程卷对卷连续式製程可减少人为接触,自动化生产亦可确保高良率,大规模生产时单位成本显着低于传统製程。
